경계현 사장 회의적 입장, 고객사도 시큰둥
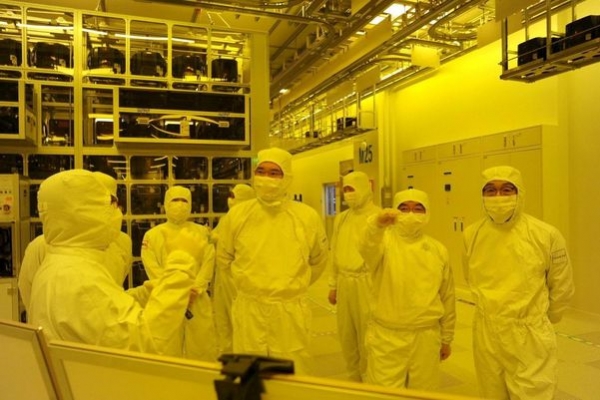
삼성전자가 첨단 반도체 패키징 투자 재검토에 들어갔다. 팬아웃웨이퍼레벨패키지(FoWLP)가 대상이다. 당초 지난해 말 천안사업장에 생산 라인을 마련하고 신형 엑시노스 애플리케이션 프로세서(AP)에 적용할 계획이었다.
FoWLP는 인쇄회로기판(PCB)이 필요 없는 패키징 기술이다. 칩(Die)을 실리콘 웨이퍼에 직접 실장해 더 얇고 높은 성능의 반도체를 만들 수 있다. 대만 TSMC가 애플 칩을 위탁생산(파운드리)할 수 있었던 원동력으로 꼽힌다. 이번 투자 재검토로 삼성전자의 차세대 반도체 패키징 경쟁력 확보가 늦어질 수 있다는 전망이 나온다.
26일 업계에 따르면 삼성전자는 FoWLP 투자를 사실상 보류한 것으로 전해졌다. 최근 경계현 사장이 장성진 테스트&시스템 패키징(TSP) 총괄(부사장), 최경세 패키지 개발실 부사장 등 주요 임원이 참석한 회의에서 FoWLP 투자에 회의적인 의견을 낸 것으로 알려졌다. 확실한 고객사를 확보하지 못했고 생산 라인을 제대로 활용하기 어렵다는 계산으로 풀이된다. 당초 관련 투자 규모는 2000억원대로 추정돼왔다.
엑시노스를 사용하는 삼성전자 무선사업부를 비롯해 퀄컴 등 주요 고객사들의 반응도 미적지근했다는 후문이다. 칩 위에 칩을 얹어서 쓰는 기존 패키지 온 패키지(PoP) 방식으로도 원하는 만큼 성능을 낼 수 있기 때문으로 보인다.
FoWLP 투자는 지난해 하반기부터 구체화됐다. 천안사업장의 패널레벨패키지(PLP:Panel Level Package)보다 상대적으로 투자액이 적게 들어가고, 범핑 장비도 그대로 활용할 수 있어서다. 범핑은 실리콘 칩 표면에 전기가 통하는 돌기(Bump)를 형성한 후 기판과 전기적, 물리적으로 접합하는 패키지를 말한다.
한 업계 관계자는 "투자가 확정됐다면 얼마전 발표한 엑시노스 2200 다음 버전부터 FoWLP가 적용됐을 것"이라며 "실제 투자를 했을 때 생산 라인 가동률이나 손익분기점 달성이 쉽지 않았다고 판단한 것으로 보인다"고 설명했다.
업계에선 천안사업장 PLP 라인 가동률이 좀처럼 올라오지 못하는 것도 영향을 끼친 것으로 분석한다. 이 곳에선 갤럭시와치와 같은 스마트워치용 제품이 생산되고 있다. FoWLP 생산 라인을 충분히 가동할 수 있을 정도의 고객사 확보가 없다면, 당분간 투자가 쉽지 않다는 관측이다.
또 다른 업계 관계자는 "삼성전자 내부적으로 투자 리스크를 감당하기 쉽지 않다는 판단이 나올 수밖에 없는 상황"이라며 "다만 중장기적으로 FoWLP, PLP 투트랙은 계속 유지할 계획"이라고 덧붙였다.

