[세미콘코리아 2019 전시참가 기업]
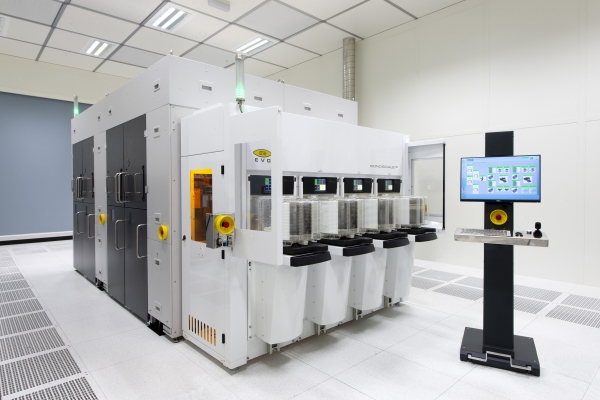
EV그룹(EVG)은 세미콘 코리아 2019에서 신형 본딩 장비 ‘본드스케일(BONDSCALE)’을 선보인다고 밝혔다. 오스트리아에 본사가 있는 EVG는 반도체 웨이퍼 본딩 및 리소그래피용 장비 전문 업체다.
이 장비는 M3D(Monolithic 3-Dimension) 같은 첨단 칩 제조 공정에 활용될 수 있다. M3D는 실리콘관통전극(TSV)처럼 다양한 소자를 병렬(parallel)로 작업한 후 결합하는 것이 아닌, 순차적으로 집적(sequential integration)해가며 쌓아 올리는 방식을 의미한다.
국제전기전자기술자협회(IEEE)가 주축으로 작성한 국제 디바이스·시스템 로드맵(IRDS)에 따르면 M3D 같은 생산 공정은 향후 시스템반도체 성능을 끌어올리는 핵심 요소가 될 것으로 관측되고 있다. 후면 열 발산 구조, 로직칩 위로 메모리를 올리는 공법, 클러스터형 적층 등을 포함해 상보성금속산화막반도체(CMOS) 기술을 뛰어넘는 새로운 형태 반도체가 M3D 같은 공법을 활용할 것으로 분석되고 있다.
EVG는 웨이퍼 본딩 기술을 반도체 전공정에 적용함으로써 로직 디바이스의 성능 향상 걸림돌을 해결할 수 있게 됐다고 설명했다. EVG 본드스케일 장비에는 세정, 플라즈마 활성화, 정렬, 사전 본딩 및 적외선(IR) 검사 등 M3D 같은 퓨전 본딩에 필요한 모든 기술이 통합돼 있다. 또한 신규 웨이퍼 핸들링 시스템과 광학 엣지 정렬 기술을 동시에 적용, 본딩 작업시 웨이퍼 끝단(엣지) 정렬 능력을 강화했다고 설명했다. 이 덕에 신 장비는 기존 본딩 장비 대비 생산성이 크게 향상됐다.
폴 린드너 EVG 최고기술책임자(CTO)는 “본드스케일 장비는 한층 더 높은 수준의 생산성을 구현했다”면서 “무어의 법칙 그 후의 시대를 위한 차세대 로직 및 메모리 디바이스에 필요한 고성능, 저전력, 좁은면적 요구를 달성할 수 있을 것”이라고 말했다.
EVG 본드스케일 장비는 이미 고객사로 출하가 이뤄지고 있다.

